Samsung Announces Availability of its Silicon-Proven 3D IC Technology for High-Performance Applications
Samsung ŌĆśXŌĆæCubeŌĆÖ enables industry-first 3D SRAM-logic working silicon at 7nm and beyond.
Bandwidth and density can be scaled to suit diverse design requirements in emerging applications.
Korea on August 13, 2020 ŌĆö Sam┬Łsung Elec┬Łtro┬Łnics, a world lea┬Łder in advan┬Łced semi┬Łcon┬Łduc┬Łtor tech┬Łno┬Łlo┬Łgy, today announ┬Łced the imme┬Łdia┬Łte avai┬Łla┬Łbi┬Łli┬Łty of its sili┬Łcon-pro┬Łven 3D IC pack┬Ła┬Łging tech┬Łno┬Łlo┬Łgy, eXten┬Łded-Cube (XŌĆæCube), for todayŌĆÖs most advan┬Łced pro┬Łcess nodes. Lever┬Łaging SamsungŌĆÖs through-sili┬Łcon via (TSV) tech┬Łno┬Łlo┬Łgy, XŌĆæCube enables signi┬Łfi┬Łcant leaps in speed and power effi┬Łci┬Łen┬Łcy to help address the rigo┬Łrous per┬Łfor┬Łmance demands of next-gene┬Łra┬Łti┬Łon appli┬Łca┬Łti┬Łons inclu┬Łding 5G, arti┬Łfi┬Łci┬Łal intel┬Łli┬Łgence, high-pe
ŌĆ£SamsungŌĆÖs new 3D inte┬Łgra┬Łti┬Łon tech┬Łno┬Łlo┬Łgy ensu┬Łres relia┬Łble TSV inter┬Łcon┬Łnec┬Łtions even at the cut┬Łting-edge EUV pro┬Łcess nodes,ŌĆØ said Moon┬Łsoo Kang, seni┬Łor vice pre┬Łsi┬Łdent of Foundry Mar┬Łket Stra┬Łtegy at Sam┬Łsung Elec┬Łtro┬Łnics. ŌĆ£We are com┬Łmit┬Łted to brin┬Łging more 3D IC inno┬Łva┬Łti┬Łon that can push the boun┬Łda┬Łries of semiconductors.ŌĆØ
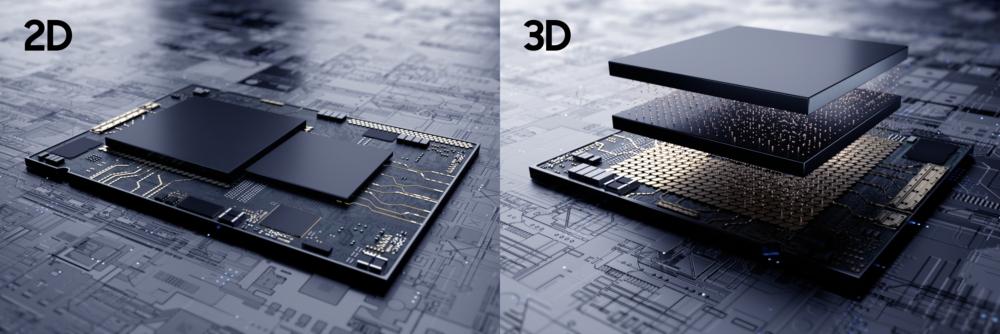
With SamsungŌĆÖs XŌĆæCube, chip desi┬Łgners can enjoy grea┬Łter fle┬Łxi┬Łbi┬Łli┬Łty to build cus┬Łtom solu┬Łti┬Łons that best suit their uni┬Łque requi┬Łre┬Łments. The XŌĆæCube test chip built on 7nm uses TSV tech┬Łno┬Łlo┬Łgy to stack SRAM on top of a logic die, free┬Łing up space to pack more memo┬Łry into a smal┬Łler foot┬Łprint. Enab┬Łled by 3D inte┬Łgra┬Łti┬Łon, the ultra-thin packa┬Łge design fea┬Łtures signi┬Łfi┬Łcant┬Łly shorter signal paths bet┬Łween the dies for maxi┬Łmi┬Łzed data trans┬Łfer speed and ener┬Łgy effi┬Łci┬Łen┬Łcy. Cus┬Łto┬Łmers can also sca┬Łle the memo┬Łry band┬Łwidth and den┬Łsi┬Łty to their desi┬Łred specifications.
Sam┬Łsung XŌĆæCubeŌĆÖs sili┬Łcon-pro┬Łven design metho┬Łdo┬Łlo┬Łgy and flow are available now for advan┬Łced nodes inclu┬Łding 7nm and 5nm. Buil┬Łding on the initi┬Łal design, Sam┬Łsung plans to con┬Łti┬Łnue col┬Łla┬Łbo┬Łra┬Łting with glo┬Łbal fab┬Łless cus┬Łto┬Łmers to faci┬Łli┬Łta┬Łte the deploy┬Łment of 3D IC solu┬Łti┬Łons in next-gene┬Łra┬Łti┬Łon high-per┬Łfor┬Łmance applications.
More details on Sam┬Łsung XŌĆæCube will be pre┬Łsen┬Łted at Hot Chips, an annu┬Łal con┬Łfe┬Łrence on high-per┬Łfor┬Łmance com┬Łpu┬Łting, which will be live┬Łstrea┬Łmed Aug. 16ŌĆō18.
